Vishay推出无线充电Tx和Rx线圈,耐潮能力达90 % RH,节省空间
judy -- 周二, 09/24/2024 - 10:06
器件体积小,额定功率30 W,工作温度达 +105 °C,饱和电流为22 A

器件体积小,额定功率30 W,工作温度达 +105 °C,饱和电流为22 A

全极 AH352xQ 会在 S 极或 N 极的磁通量密度超过 BOP 时启动,低于 BRP 时关闭。有三种高灵敏度可供选择,范围介于 ±20G 到 ±40G BOP。

GSE20A系列预置了CCC3.0 Applet,开发者只需将NFC/BLE通信芯片接收的数据直接透传至Applet,无需深入了解数字钥匙的复杂协议规范

本文将为您介绍Amazon Sidewalk的架构与应用,以及由Silicon Labs所推出的Amazon Sidewalk解决方案,与Matter标准的最新发展。

本文白皮书从静态功率损耗分析、动态功率损耗分析、栅极驱动损耗分析等方面进行了全面介绍
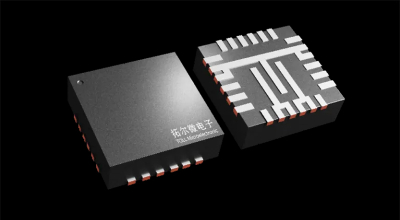
TOLL适时推出一款可支持45W的内置4-MOSFET的升降压转换器,具有易散热,高效率,小体积的特点,外加工作频率可调

本文首先介绍了一个典型的共射极放大器,然后探讨了发射极旁路电容器的工作原理。

IDC最新发布的《AR/VR头显市场季度追踪报告》显示,2024年上半年,中国AR/VR头显出货23.3万台(sales-in口径),同比下滑29.1%。

这款霍尔传感器芯片提供两条完全独立的信号通道,以最大限度地减小抖动并始终保持90°相移,且不受磁极距离影响。

RJ1040是一款应用于CAN协议控制器和物理总线之间的接口芯片,完全符合ISO11898标准。具有在总线与 CAN 协议控制器之间进行差分信号传输的能力