T2PAK应用笔记重点介绍T2PAK封装的贴装及其热性能的高效利用。内容涵盖以下方面:T2PAK封装详解:全面说明封装结构与关键规格参数;焊接注意事项:阐述实现可靠电气连接的关键焊接注意事项;湿度敏感等级(MSL)要求:明确器件在处理与存储过程中的防潮防护规范;器件贴装指南:提供器件贴装的最佳实践建议。我们已经介绍了
在硬件设计中,换流回路是一个关键考量因素,尤其在高速开关应用中更为重要。减小该回路中的寄生电感可直接降低开关损耗,并提升系统整体效率。
顶部散热封装(如T2PAK)在此方面相比底部散热封装具有明显优势。其热设计允许更灵活的电气布线,从而实现更紧凑、更优化的换流回路。
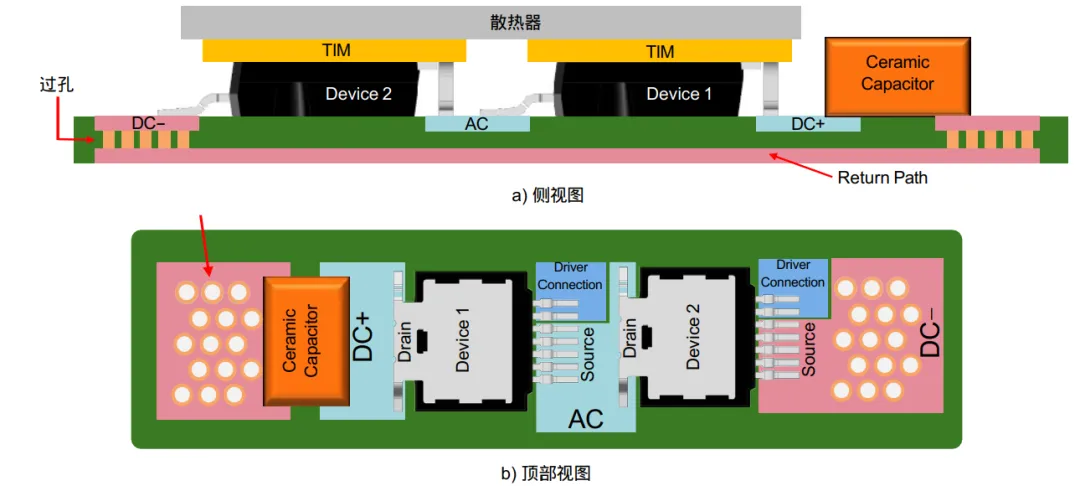
图:硬件设计中的换流回路建议
如图所示,通过将两个T2PAK器件并排布置,即可实现半桥拓扑结构: DC+ 连接到器件1的漏极; 器件1的源极连接到器件2的漏极; 器件2的源极再连接至DC-。
为构成完整的换流回路,回流路径可通过PCB底层布线,并与顶层安装的器件平行走线。通过过孔将顶层与底层互连,从而形成紧凑的回路结构。这种布局有助于实现磁通量抵消,显著降低寄生电感。在双脉冲测试(Double Pulse Test, DPT)中,该布局实现了仅9 nH的回路电感,充分验证了其有效性。
相比之下,底部散热封装依赖PCB底层铜箔进行散热,这限制了底层电气布线。此限制使得难以构建紧凑的换流回路,往往导致走线路径更长、寄生电感更高。由于底层必须专用于散热——通常需通过大量热过孔和大面积覆铜实现——将回流路径紧邻电源回路布线变得不切实际。这会削弱磁通量抵消效果,增加回路电感,从而对开关性能产生不利影响。
总体而言,顶部散热封装相比传统表面贴装器件(SMD)具有更优的热性能,因为它能够直接从外露的金属焊盘(MOSFET的漏极、IGBT的集电极、整流器的阴极)导出热量,避免了底部散热封装中PCB材料造成的热阻。如前所述,要充分发挥其散热优势,必须精心设计功率器件所处的散热系统。
