本文要点
MCM 封装将多个芯片集成在同一基板上,在提高能效与可靠性的同时,还可简化设计并降低成本。
MCM 封装领域的最新进展包括有机基板、重分布层扇出、硅中介层和混合键合。
这些技术能够提升 MCM 设计的信号完整性、性能和功率分配效率。
多芯片组件(Multi-chip module,即 MCM)封装作为电子组装和芯片封装领域的一项关键技术,将多个集成电路(IC)、半导体裸片和分立元件集成在同一基板上,结构紧密且性能卓越,堪比大型集成电路。在本文中,我们将探讨 MCM 封装的最新趋势、关键技术及其在功效、可靠性、简化设计和成本效益方面的优势。

什么是 MCM 封装
MCM 是一种将多个集成电路或“芯片”、半导体裸片和/或其他分立元件集成在同一基板上的电子封装技术,通常具有多个导体端子或“引脚”,可作为大型集成电路使用。MCM 封装常被称为“异构集成”或“混合集成电路”。
MCM 封装的覆盖范围较广,从在小型印刷电路板(PCB)上使用预封装集成电路来模仿现有芯片封装的 footprint,到在高密互连(HDI)基板上集成大量裸片的完全定制芯片封装。
MCM 封装新趋势
在 MCM 中用于连接集成电路的互连基板被称为中介层,采用含碳或硅的层压电路板等有机材料,如下方讨论的高带宽记忆器(high-bandwidth memory,即 HBM)。不同材料各有优劣。相较于独立集成电路,采用中介层连接多个集成电路可降低信号传输功耗、增加传输通道数量,并最大限度地减少电阻/电容引起的延迟(RC 延迟)。然而,其芯粒间通信的功耗和延迟仍高于单块集成电路。
目前值得关注的四大 MCM 封装技术包括:
有机基板
这种 2D 标准封装成本较低,广泛应用于半导体行业,尤其适用于 IO 密度不高、裸片间互连较少的场景。不使用脆弱易损的微凸块,良率较高。在该结构下,各裸片直接连接基板,MCM 通常通过 BGA 连接至更大的电路板上。
重分布层(RDL)扇出
作为较新的 2.5D 高级 MCM RDL 扇出封装形式,其密度与硅中介层相当,但成本和复杂度更低。支持单裸片或多裸片组装,有助于提升性能和 IO 能力,适用于物联网、网络和计算领域。
硅中介层
在这种 2.5D 封装中,硅基中介层连接两个裸片。使用微凸块垂直互连技术实现堆叠裸片的密集连接。由于这类封装的组装十分复杂,加上微凸块脆弱易损,因此存在较多的良率问题。为此,封装供应商提供质量保障措施和测试及修复机制,有效解决了这个问题。
混合键合
这种 3D 堆叠封装技术实现了最高的密度和能效。提供用于连接的硅过孔(TSV),将两个晶圆键合在一起。混合键合可最大限度地减少驱动通道时的功耗,并可根据需要降低每个 IO 的功耗。不过,与中介层相比,该技术对复杂性和成本提出了更高的要求。混合键合又称为芯片堆叠封装。就某些集成电路而言,特别是存储器,在系统中多次使用时,其引脚排列极为相似或相同。经过精心设计的基板可将这些裸片以垂直方式堆叠,从而显著缩小 MCM 的 footprint(尽管代价是芯片变厚或变高)。
值得一提的是,在第四类 MCM 封装中,裸片间互连的复杂度关系到封装内两个或多个裸片之间的通信。因此,需针对每种封装的特点,优化裸片间通信接口。例如,当中介层并不支持通道间高速通信,可以采用高速裸片到裸片接口 IP。
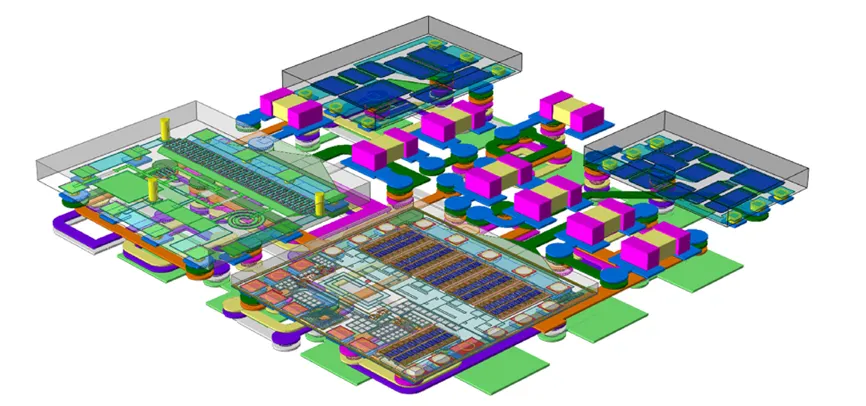
单个 MCM 可能采用多种不同的技术
MCM 的优势
MCM 具有以下优势:
低功耗
与采用独立电子元件的系统相比,MCM 的功耗更低。因为所有必要器件均集成在同一组件上,互连长度大幅缩短,从而降低功耗需求。
高可靠性
MCM 封装将多个芯片集成在单个 PCB 电路板上,器件之间的互连较少,组件的故障点也随之减少,从而提升了可靠性。
结构简化
采用 MCM 的 PCB 电路板能够集成多种功能,有助于构建柔性电子设备,满足各种应用需求。此外,简化的设计也有助于加速产品生产,缩短上市周期。
低成本
得益于 MCM 的上述优势(低功耗、高可靠性和结构简化),生产成本也随之降低。综上所述,MCM 为电子组装提供了一种极具成本效益的解决方案。
随着业界对先进 MCM 封装的需求不断增长,选择适当的设计工具至关重要。Allegro X Advanced Package Designer 是专为 MCM 封装设计与优化打造的综合软件解决方案,可助您发挥 MCM 封装设计的全部潜力。
文章来源:cadence
